第43回UV/EB研究会 聴講記
今回の研究会では、レーザー誘起放射線という新しい概念の放射線源、および薄膜処理に特化した超低エネルギー電子線源の開発。イオン注入法を用いた高分子材料の処理について最新の話題を提供していただきました。(平成21年11月20日 於:住友クラブ)
1.高強度レーザー誘起放射線(電子・イオン)の現状と工業分野への展開について(会員ページ)
光産業創成大学院大学 沖原 伸一朗
大型のレーザーを用いるレーザー誘起放射線は以前から、各国でレーザー核融合の研究の中で調べられていました。それに対して、できるだけコンパクトなレーザーを使って放射線を発生させ、工業用途に応用できないかという研究を紹介していただきました。
図1は、レーザーを材料に照射してプラズマを発生させると出てくる放射線を示しています。ターゲットは金属のフィルム、ガスジェット、コーティングしたもの等でここから発生するのは、電子・イオン・X線です。ターゲットを変える事で利用したい放射線が得られる。そういった意味で、このレーザー誘起放射線という技術は、光を電子ビームとかイオンビームに変換するシステムと言えます。
レーザー誘起電子ビームを加速するには、自己変調航跡場による加速を用いる。HeやN2などのガスジェット中に集光強度が1018W/cm2以上のレーザーを照射すると、電子密度が1018〜1020/cm3くらいの密度の低いプラズマができ、そのプラズマ中に100 fs位のパルス幅の高強度レーザーが伝播してくるとプラズマの疎密波が生じて、電子群を光速近くまで加速できる。
イオンの加速は静電場加速法を使っています。電子の場合と同様に高強度レーザーパルスを、厚さ数μmの薄膜ターゲットへ照射すると、表面で加速された電子が最初に薄膜の裏側に突き抜けて高エネルギー電子雲を作る。このときに発生した高密度プラズマに電子雲からのクーロン力が作用しイオンが引き出され、さらに電子雲と薄膜間の静電場により数MeVに加速できる。かなり大きなレーザーを使った場合、陽子で、60 MeVというエネルギーが出ます。がん治療には200 MeVの陽子線が使われていますので、その4分の1ぐらいまではこの方法で出る。

レーザー誘起放射線の特徴は、レーザーを絞るためスポット光源であり、高ピーク輝度で短いパルスで打ち込むためにかなり短い時間で発生する。そのため発生線量を少なくコントロールできるので生体負荷が極めて少ない照射が可能ですが、電流量が少なく線量も少なくてエネルギースペクトルが広いのが難点です。ターゲットの形状や密度を変えることで、単色エネルギーピークを出す研究が進められている。
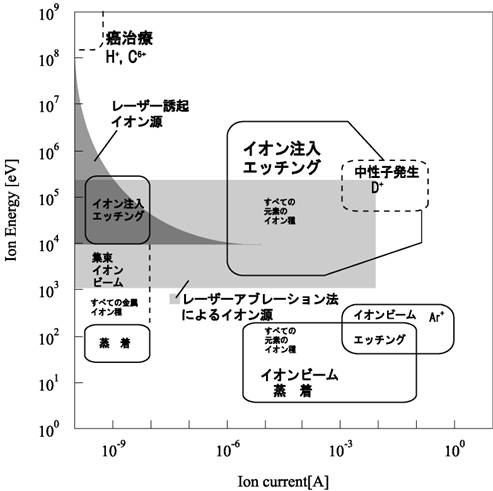
図2 イオンビーム応用例と現状のレーザー誘起イオン源との関係
イオンビームの工業利用では薄膜形成で数百eV、表面改質で数MeVぐらいのエネルギーを利用しています。レーザー誘起イオンビームでもこの程度のエネルギーを出すことができます。しかし電荷量が数百pCであるため、6桁以上電荷収量を上げる事が出来れば、実現できそうです。現状では図2に示すようにイオン注入エッチングに利用できる段階です。数百keVの領域では安価なナノ秒レーザー装置を用いたレーザーアブレーション法と競合する
放射線源として発展させるためには、レーザーが10TWクラスで長時間安定動作する必要がある。レーザーだけでも1億円相当かかるので、それを安く下げさらに、装置全体の安定化や品質保証が必要になってくる。そうなると図3のような工業分野への展開が可能となる。

図3 レーザー誘起電子・イオンの工業分野への展開
レーザー放射線源という新たな光源を使って産業を興すための3つの要素として、1つは装置の安定性、2つ目はビームの品質向上で、3つ目としては人材育成が必要です。こういった研究を進めるにあたって、国とかそういったところと連携を組んで進めるコーディネート的な役割とか、その技術を支える中核になれる人材が必要なので、そういった方々を育てるために是非、うちの大学に皆さん集まっていただいて、一緒にやりませんかという事で、光産業創成大学院大学を紹介していただきました。
2.超低エネルギー電子線照射源
EB-ENGINEⓇの開発とその応用(会員ページ)
浜松ホトニクス株式会社電子管事業部 第5製造部 松井 信二郎
近年薄膜処理プロセスが増加している。これらに従来のエネルギーの高い(150 keV以上)電子線処理をすると様々な問題が発生することが報告されている。薄膜処理に限定した電子線照射源として浜松ホトニクス社が開発した加速電圧が40kV〜110 kVのEB-ENGINEⓇについて、超低エネルギー電子線の特徴と製品の開発経緯・応用について紹介していただいた。
表1に示すように電子線照射の用途は電子線の飛程(浸透深さ)によって分けられる。100μm以下の薄膜を処理するのに、100keV以上の電子線を照射すると薄膜の後ろにある基材まで電子が浸透し、発熱、着色、劣化、歪みなどの悪影響を及ぼす。超低エネルギー電子線を使うメリットは飛程が短いだけでなく、加速電圧を低く出来るため装置を小型化でき、副次的に発生するX線のエネルギーも低くなるため、X線遮蔽が簡素化されるため、装置全体の軽量化と小型化に繋がる。薄膜へのエネルギー付与効率が高くなるため、装置全体の省電力化が達成される。
電子線のエネルギー付与過程をPENELOPEというコードを使ったモンテカルロ法でシミュレーションできます。図4は種々のエネルギーの電子線を密度rの物質中に照射したときの深さ方向のエネルギー付与を示している。300keVのエネルギーでは飛程が長いため、大部分のエネルギーを100μm以上の深さに与えているのが分かる。一方、40keVの電子線では表面10μmまでに大部分のエネルギーを与え、40μmまでに全てのエネルギーを失っている。10μm薄膜へのエネルギー付与率と薄膜以降へのエネルギー付与率を計算してみると、加速電圧が40kVでは薄膜に49.8%、薄膜以降に29.8%で、70kVでは14.0%と77.8%と薄膜以降へのエネルギー付与率が高くなり、300kVでは薄膜へのエネルギー付与率はわずか0.91%に落ちてしまう。したがって、超低エネルギー電子線は薄膜表面付近に効率よくエネルギーを付与するといえる。

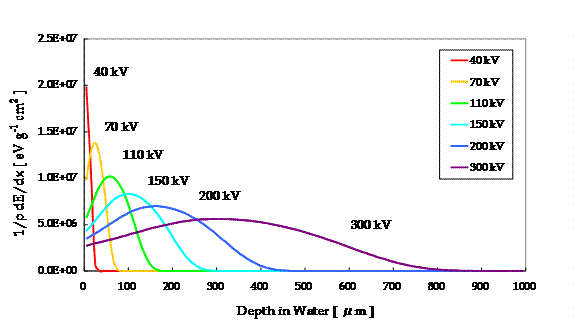
図4 電子線の物質中での深さ方向エネルギー付与
イオン注入法で用いるイオンビームのエネルギーは通常1 keV程度から数百keVの範囲である。このエネルギー範囲における物質とイオンビームの相互作用は、大きく二つの相互作用に分けられる。一つは標的原子との弾性散乱であり、入射したイオンはエネルギーを失い、進行方向が変わると同時に標的になった原子に反跳エネルギーを与える。反跳する原子は標的材料の構造を破壊し、アモルファス化をもたらす。もうひとつは標的中に存在する電子との非弾性散乱であり、イオンの進行方向はほとんど変えないが標的原子をイオン化し、これがラジカルの発生、化学的な分解と再結合といったX線、電子線照射においても見られる放射線照射の効果を生み出す。
しかしながらイオン注入によりもたらされる効果には次の2点の差異がある。ひとつは、空間的な分布の差ともうひとつは付与されるエネルギーの密度の差である。X線は標的材料の表面から指数関数的に減衰する分布であり、また電子線は一定の飛程を持つけれども深さ方向にはだらだら下がるような線量分布を示す。これに対してイオン注入の場合にはある飛程でもって明確に効果はゼロになる。図6にシミュレーションソフトSRIMで計算した100
keVのCイオンを炭素材料に注入した場合のイオンの深さ方向の分布を示す。照射の効果をこのように表面のある狭い領域に限ってもたせることができることがX線、電子線照射にはない特徴である。

図6 注入したCイオンの深さ方向の濃度分布
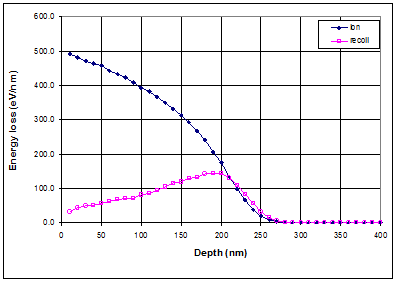
図7 導入された100 keVのエネルギーが吸収された量の深さ方向の分布
図7に示されるように280
nm程度の深さまでしか損傷は導入されないのに対して、100 keVの電子線はフェーザーの実験式によれば75 μm程度まで損傷が導入されるので、単純に考えても同じ粒子数あるいは電流量の電子線を照射しても吸収されるエネルギーの密度は2桁以上小さくなる。このように、狭い限定された領域に高密度の損傷を導入することができることがイオンビームの特徴である。図7から、表面付近では入射したイオンから直接標的材料に付与されるエネルギーが大半であるのに対し、深さ200 nmから停止する270
nmまでは、イオンが直接付与するエネルギーと反跳原子を経由して付与するエネルギーがほぼ当量であるのが分かる。
また、構造を破壊し材料のアモルファス化をもたらすメカニズム(原子による散乱の効果)はイオンビーム照射に特有のものである。この効果は、損傷が導入される時点においては、周囲の化学的な結合状態には大きな影響を受けないため、X線、電子線では損傷を与えることが困難な材料あるいは結合部位に対して損傷を与えるといったことも原理的には可能であろう。量的にも、注入されたイオンの量よりも2桁から3桁多い欠陥がこの過程で導入されることにも注意が必要である。計算では100 keVのCイオン1個が炭素材料中に入射してから停止するまでに317個の欠陥が生じる。
高分子材料に対するイオン注入は1980年代から報告されているが、X線、電子線照射でも出来るものが多かった。イオン注入法でしか出来ない特性としては電気伝導度の改善がある。イオン注入により高分子表面付近の水素原子や酸素原子がスパッタリングによって放り出される材料表面の炭化によるものと考えられる。
同じように損傷付与を利用した応用例として微小な穿孔を空け、フィルターとして利用出来るポリカーボネートのフィルム作成がある。穴の密度はイオン注入量によって制御できるが、穴の位置は制御できない。穴径の制御はイオン注入後のエッチングの条件によって制御できるとの事であった。
前の2例は材料の損傷を利用した例である。高分子材料に対するイオン注入は、損傷の効果が目に付きすぎるため、ほとんど報告されてこなかったが、元素導入を利用した応用として、京都工芸繊維大学の奥林先生との共同研究で、りんイオンを注入し難燃性のフィルム作成に成功され、特許申請中との事であった。
(阿部・福島記)