��26��UV/EB�������
�@����16�N5��14���J�ÁA���@�Z�F�N���u
����͔��ו`��쐬�̎�����Z�p�ƐV���������ޗ��Ƃ��Ẵ|���V�����ɂ��Ęb���Ė�����B
���i�����̔����̋Z�p�̓������[�̏W�ϓx����N���œ�{�ɂȂ�ƌ����A������u���[�A�̖@���v�ŕ\�������悤�ɖڊo�܂������̂�����B�������[�͏����Ȕ����̃`�b�v�̏�ɔ��ׂȑ���`�����ƂŎ�������A�����Ɏʐ^����ގ��̌��w���\�O���t�B�[�Z�p���g���邪�A�W�ϓx���オ��ɂ�ĕK�v�ȉ𑜓x�邽�߂ɁA�g������̔g�����ǂ�ǂ�Z���Ȃ��Ă���B���ہA�ŋ߂̌�����ArF(193nm)�̃G�L�V�}���[�U�[���嗬�ƂȂ��Ă��邻�������A�����̃f�U�C���̍���̕K�R�I�Ȑi���ɑΉ����邽�߂ɂ́A�����ȊO�ɂ����܂��܂ȍH�v���l������B�ŏ��̎O��͂��ꂼ��قȂ������ꂩ��̋Z�p���Љ�Ė�����B���ɁA��̂���l�͂�������x���`���[�r�W�l�X�𗧂��グ�A�����Z�p�̐擱�҂Ƃ��Ċ���Ă���Ƃ̂��Ƃł���B
�����g�����\�O���t�B�[�ł́A�𑜓x�̓�/NA�i��:�����̔g���ANA:�����Y�J����=sin�ƃ�:�����Y�ւ̊J���p�j�ɔ�Ⴗ��̂ŁA�� �����������邩�A�������̃Ƃ�傫������Ό��シ��B��҂̋Z�p�Ƃ��ĉt�Z�@�iLiquid Immersion Lithography�j������B�O�҂ł͌�����F2(157nm)�AEUV(�iExtreme Ultraviolet�A13.4nm)���g�����������邪�A���ꂼ��ɃN���A�����ׂ���肪����B
����A�𑜓x���ɂ߂č����d�q���iEB�A0.1nm�ȉ��j�̗��p������BEB�@�͐��Y���i�X���[�v�b�g�j���Ⴂ�Ƃ���邪�A������x�A�n�ӂƍH�v�ŃJ�o�[�o����_���������A���W�X�g�� �p�^�[�����Ă��t���鎞�ɕK�v�ȃ}�X�N�̉��i�������Ƌ��ɔ���I�ɍ������čs�����߁A�}�X�N���X���\��EB��65nm�m�[�h�ȍ~�̗L�͂Ȍ��ƌ�����BJSR�ł͂��������̈�̕����ƌ��āAEB�ʼn��H�o���郌�W�X�g�̍ޗ��ɂ��Č����J�������Ă���B
�p�^�[�����Ă��t���鎞�ɕK�v�ȃ}�X�N�̉��i�������Ƌ��ɔ���I�ɍ������čs�����߁A�}�X�N���X���\��EB��65nm�m�[�h�ȍ~�̗L�͂Ȍ��ƌ�����BJSR�ł͂��������̈�̕����ƌ��āAEB�ʼn��H�o���郌�W�X�g�̍ޗ��ɂ��Č����J�������Ă���B
���W�X�g�̍ޗ��͍����q�̉��w���猩�đ����^�Ɣ��^������B���^�͍����q�ւ̒��ڂ̕��ː����w�����𗘗p������̂ŁA�卽����^���|�W���W�X�g�A�ˋ��^���l�K���W�X�g�̍ޗ��Ƃ��Ďg�p�����B�����ɂ���ĕ��q�ʂ��������Ȃ�Ɨn�܂ɗn���Ղ��Ȃ�A�ˋ��ɂ���ĕ��q�ʂ��傫���Ȃ�Ɨn����Ȃ鐫���𗘗p������̂ł���B����A���w�����^�ł́A���݂������_�����܂�����ː��ɂ����H+�������錻�ۂ𗘗p������̂ł���B�卽���q�ɃG�X�e���������������Ă����A��������H+�ɂ���ĉ����������N����A�L�@�_��������B�L�@�_�̓A���J�������t�ɉn�Ȃ̂Ń|�W�^�Ƃ��ė��p�ł���B�܂��A�A���J���n�^�̎����Ɏ_�����܂ƁAH+�ɂ���ĕ������ăA���J���n�^�̎����ƌ�������^�C�v�̉ˋ��܂Ƃ�������EB�Ǝ˂���ƁA�Ǝ˂��ꂽ�������A���J���s�n�ƂȂ�̂Ńl�K�^�̍ޗ��Ƃ��ė��p�ł���B
����܂ł��o�l�l�`�ȂǁAEB�|�W���W�X�g�Ƃ��Ďg�p����Ă����ޗ��͂��邪�ALSI�ւ̓K�p���l�����A�����ׂȍ\���ɑΉ�����ɂ͊��x�A�G�b�`���O�ϐ����ɗD��鉻�w�����^�C�v���L�͂ȍޗ��n�ƍl������B
�u���ł͂����̊ϓ_�ɗ����ă|�W���W�X�g�̂��߂̃x�[�X�����A�_�����܁A�N�F���`���[�̑g���Ɗ��x�A�𑜓x�ALER�i���C���G�b�W�̗���j�ADOF�i�œ_�[�x�j�Ȃǂ̊֘A�����ؓI�Ɍ������A����ꂽ�V�����ޗ��̊�{�v�̃��[�h���A�����̉摜�Ƌ��ɉ�����ꂽ�B
�f�l�ڂɂ͏��Ȃ��Ƃ�90nm���x�܂ł̓N���A���Ă���̂��Ȃƌ��������A�܂��A�����\�O���t�B�[�̃��x���ɂ͒B���Ă��Ȃ��Ƃ̂܂Ƃ߂ł������B
�Q�DLow Energy Electron-beam Projection
Lithography �� LEEPL �� �̏Љ�
�i���j���[�v���J������@�얖 ��
�P�D�ŏq�ׂ�ꂽ�悤�ɁA�����ナ�\�O���t�B�[�̌����Ƃ��āA�����������Ƃ����F2��EUV�ɋ������ēd�q�����L�]������Ă��邪�A���̎�v�Ȗ��_�͐��Y���i�X���[�v�b�g�j���ƌ����Ă� ��B�������A�𑜓x��������ɁA�œ_�[�x���[�����Ƃ�A�d��A����Ŏ����A�Ό����\�Ȃ��ߍ����Ήp�ACaF2�Ȃǂ̍����ȃ����Y��K�v�Ƃ��Ȃ����_������B���̂悤�ȃo�b�N�O���E���h�ɗ����A���オ�ւ�閈�ɘI�����u�̉��i���ɒ[�ɍ�������A�����锼���̃��\�O���t�B�[�̊�@��Ŕj���邽�߂ɁA�������[�J�[�ł��w���\�ȑ��u��ڎw����LEEPL���J�������B
��B�������A�𑜓x��������ɁA�œ_�[�x���[�����Ƃ�A�d��A����Ŏ����A�Ό����\�Ȃ��ߍ����Ήp�ACaF2�Ȃǂ̍����ȃ����Y��K�v�Ƃ��Ȃ����_������B���̂悤�ȃo�b�N�O���E���h�ɗ����A���オ�ւ�閈�ɘI�����u�̉��i���ɒ[�ɍ�������A�����锼���̃��\�O���t�B�[�̊�@��Ŕj���邽�߂ɁA�������[�J�[�ł��w���\�ȑ��u��ڎw����LEEPL���J�������B
���̊�{�R���Z�v�g�́A�܂��A���۔����̋Z�p���[�h�}�b�v�iITRS�j�ɓK�������鑕�u�Ƃ��邽�߂ɁA�𑜓x�̍���EB��I���������ƂƁA�傫���X���[�v�b�g�ƒቿ�i���m�ۂ��邽�߂Ƀ}�X�N�g�p�������̗p�������ƁB�܂��A�ቿ�i�т̑��u���������邽�߂ɋߐړ]�ʖ@���̗p�������ƁA�Ȃǂł���B
���ۂɊJ���������u�͐}�Q�̂悤�ȍ\���������Ă���B��{�I�ɂ͓d�q�e�ƕ��s�@�̍\������Ȃ�Ɩ����̉��ɁA�}�X�N�ƃE�G�n�[��30�`90��m�̃M���b�v�Ŕz�u���ă}�X�N�����E�G�n�[��ɓ]�ʂ�����̂����A���̓�����
�@�k�����e�����Y���s�v�ȕ��s�r�[���ɂ��ߐړ]�ʂɂ���č\�����ȈՂɂ��A��R�X�g����}�����B
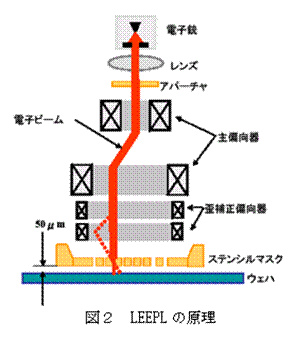 �A��G�l���M�[�i2keV�j���̗p���邱�Ƃɂ��A�������W�X�g���x��Ƌ��ɁA�}�X�N�A�E�F�n���ɔM���������Ȃ����߃_���[�W�����Ȃ��A�܂��A�ߐڌ��� (��Ղ���̌���U��)���ԓd���ʂ̉e���������̂ŕ���s�v�ȂǁA�̂Ȃ������𑜓x��������i�����X���[�v�b�g�j�B
�A��G�l���M�[�i2keV�j���̗p���邱�Ƃɂ��A�������W�X�g���x��Ƌ��ɁA�}�X�N�A�E�F�n���ɔM���������Ȃ����߃_���[�W�����Ȃ��A�܂��A�ߐڌ��� (��Ղ���̌���U��)���ԓd���ʂ̉e���������̂ŕ���s�v�ȂǁA�̂Ȃ������𑜓x��������i�����X���[�v�b�g�j�B
�B���{���X�e���V���ɂ��}�X�N�쐬�̕s���͕��Ό����p�������ׂȐ���ɂ�鐫�\�̌���i�}�X�N��E�G�n�c�݂̕�Ȃǁj�ƁA�����d�ˍ��킹���x����сA���w��̕s�v���Ȃǂ����܂��Ė��ߍ��킹���A�ቿ�i���ɂ���^�����B���̕ӂ�̊֘A�Z�p�͌���32�Ђ̃R���\�[�V�A�������A�����J�����Ă�����Ă���B
���Y�̃��[�h�}�b�v�Ƃ��Ă͂��ł�2002�N�̃��ł��o���Ă���A65�`90nm�m�[�h�Ή��̂P���@��EBPrinter LEEPL-3000�̖��O�łU�����ɏo���\��ł���B�傫����ArF�X�L���i�[�Ɠ����x�ł���B�X���[�v�b�g�͂W�C���`��50���^���ƁA���̌��ő��@�̂P�^�S���x�����AEB�@�Ƃ��Ă͍ő��ł���B
LEEPL�̏ꍇ�A���u�����邱�ƂȂ���A���̊��p�x�̓}�X�N�̊����x�ɑ傫���ˑ����Ă���B�ډ��A�J�����ڂ������R���\�[�V�A���̊J���Ɉˑ����Ă��邪�A���ꂼ��̃��[�h�}�b�v�ɂ��������Đi�s������ŁA2004�N���ɂ�65nm�m�[�h�f�o�C�X�̐��Y���\�ɂ���LEEPL�֘A�Z�p�������\��ł���B
�R�D�i�m�C���v�����g�Z�p�̊J�������Ɖ��p�W�J
�L����Ѓi�m�G�t�R���T���^���g�@�ʑ��q��
�i�m�e�N�m���W�[�͒P�Ɋ����f�o�C�X�̍����x�����͂���ƌ������A10�`100nm�X�P�[���Ŕ�������V���������E���w�E�����w�I�Ȑ����ɋZ�p�v�V�̉\�������҂��Ă���B�i�m�\�����쐬����ɂ͂�����g�b�v�_�E���Z�p�łȂ��A�� �R�Ȏ��ȑg�D���Ō`�������{�g���A�b�v�Z�p���]�܂������A�����Ȏ��R���ۂɈˑ�����̂ł͍\���I�ȕs���S�������ɂȂ邽�߁A���炩���߃g�b�v�_�E���I�ɍ\�����쐬���A����𗘗p���Ď��ȑg�D�����A�V�X�g����Z���Z�p�������I�ł���B
�R�Ȏ��ȑg�D���Ō`�������{�g���A�b�v�Z�p���]�܂������A�����Ȏ��R���ۂɈˑ�����̂ł͍\���I�ȕs���S�������ɂȂ邽�߁A���炩���߃g�b�v�_�E���I�ɍ\�����쐬���A����𗘗p���Ď��ȑg�D�����A�V�X�g����Z���Z�p�������I�ł���B
���̍ۂ̃g�b�v�_�E���I�ȉ��H�Z�p�ɂ̓R�X�g��X���[�v�b�g�����ƂȂ邪�A�\�P�Ɏ������e��i�m���H�Z�p�̒��ɂ����āA�i�m�C���v�����g�͂��̉����Ɏ�����^����B
�����͔��ɃV���v���i�}�R�j�ŁA������̋Z�p�ɉ��p����ꍇ�A�܂��i�m�\���������[���h(���^)������A�ʏ�̊�ՂɃ��W�X�g������h�z������ɏd�ˍ��킹�ăv���X���A������Ƀi�m�\���̉��ʂ�����B���̌�A���^�𗣌^���ARIE�@�ƌ�������@�ŃG�b�`���O���{���A����Ɍ������������邱�ƂŊ�Տ�ɖړI�Ƃ���i�m�p�^�[��������̂ł���B���^�͍Ő�[�̃��\�O���t�B�[�Z�p���g���č쐬����̂ŁA�𑜓x�͂��̃}�X�N�Ɉˑ����邪�A����ȊO�̋Z�p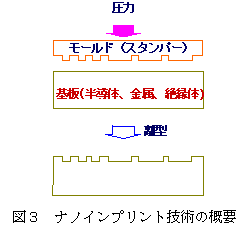 �͂قƂ�Ǖs�v�Ȃ��߁A���u�̃R�X�g���ɂ߂Ĉ����B
�͂قƂ�Ǖs�v�Ȃ��߁A���u�̃R�X�g���ɂ߂Ĉ����B
���̂悤�Ƀi�m�C���v�����g�͌������P���ň����ł��邱�ƁB�X���[�v�b�g���傫����ʐω����e�ՁB���^��⏜�k�A�Ռ��ȂǍ��x�ȕt�ѐݔ����s�v�Ȃǂ̓���������B���_�Ƃ��Ă͉𑜓x�A�Č����A���^�̍ޗ���쐬���@���ǂ����邩�Ȃǂ�����B
�ŏ���1996�N�ɕč���S. Chou��SiO2�����[���h�ɂ���PMMA�̃��W�X�g���10nm�̌�������ATi�Ȃǂ̋����ɓ����傫���̃p�^�[����]�ʂ����̂��n�܂�ŁA���̌�A�}���ɍL�܂����B���[���h�̍ޗ��ɂ�Ni�A�V���R���A�Ήp�ASiC�ȂǁA�ړI�ɉ����ĕK�v�Ȑ������������ޗ����P�[�X�o�C�P�[�X�Ɏg���Ă���B��]�ʍނɂ͔M�Y���A�M�d�����Ȃǂ̎������g���邪�A����������Ƃ��Ȃ��Ƃ��낪���ʂ̃��W�X�g�ƈقȂ�Ƃ���ŁA�]�ʂ��₷���A���`���₷���A���^���₷���A�h���C�G�b�`���O�ɐ��m�ɑΉ�����Ηǂ��B
���ɒ��ڃi�m�C���v�����g�ƌ��i�m�C���v�����g�Z�p������B�O�҂̓��W�X�g������A��Ղɒ��ڃi�m�\�����`��������̂ŃG�b�`���O�Ȃǂ��s�v�Ȃ��߁A�������I�ȋZ�p�ƂȂ�B����A��҂͊�Ղ̏�Ƀt�H�g�|���}�[�̑O��̂�h�z�����[���h���������ĂȂ�����Ăčd����������@�ł���B
���p�ʂł̓i�m�\���̋��^���肪����Ȃǂ̂ق��A�@�ψꐫ�A�Č����A�A���[���h�̌J��Ԃ��g�p�A�B�i���\���ւ̑Ή��ȂǁA�������ׂ��Z�p�I�ۑ�͑������A�w�������Ȃ��A�A���C�������g���P���ȍ����x�L�^�}�́A���w�E�\���f�o�C�X��i�m�o�C�I�G���N�g���j�N�X�E�i�m�\���V�f�ނȂǂւ̓K�p�͍���̊g�傪���ҏo����B�������A�܂��S�̓I�ɖ����n�Ȗʂ������āA�����㔼���̗ʎY�p�̃��\�O���t�B�Z�p�Ƃ��ẮA�A���C�������g���x����A���^�̌������ƏC���Z�p�Ȃǂ��傫�ȉۑ�ł���B
�S�D�L�@�|���V�����̌��d�����Ɖ��p
���{����w���_�����@���ۗ���
���͏������ς��āA�����ޗ��Ƃ��Ẵ|���V�����̘b�����Ē������B�n����̐����͂��ׂĒY�f���A�Ȃ����L�@���ō\������Ă��邪�A�Y�f�Ɠ����̌]�f���A�Ȃ�Ƃǂ�ȕ������o����̂��B�ΐ��̐����͂���ȕ����ŏo���Ă���̂ł́A�ȂǂƑz���������܂�����������������Ǝv���邪�A�u���ł͐��ɂ���ȕ����ɉȊw�̌������āA������̍ޗ��Ƃ��čl�@���Ē������B
 �Y�f���i�̗L�@�����͓d�q�����ꂼ��̌������ʂɋǍ݂��Ă���̂ɑ��āA�]�f���i�̃|���V������Si-Si�Ԃ̌����ɗ^��d�q��Si�卽�ɉ����ăh���C���ƌĂ��15�`20�͈̔͂ɍL�����Ă���_���傫�ȓ����ł���B���̂��߃|���V������d��̒��ɒu���ƁA�d�ׂ��h���C���Ԃ��z�b�s���O�ɂ���Ĉړ����錻�ۂ�������B���̎����͋z���x�ɂ����f����A����̃s�[�N�������O��ɂ���Y�f�������ɑ��A�|���V�����ł͌������̑����Ƌ��ɋߎ��O��340nm�t�߂Ɏ��ʂ���B
�Y�f���i�̗L�@�����͓d�q�����ꂼ��̌������ʂɋǍ݂��Ă���̂ɑ��āA�]�f���i�̃|���V������Si-Si�Ԃ̌����ɗ^��d�q��Si�卽�ɉ����ăh���C���ƌĂ��15�`20�͈̔͂ɍL�����Ă���_���傫�ȓ����ł���B���̂��߃|���V������d��̒��ɒu���ƁA�d�ׂ��h���C���Ԃ��z�b�s���O�ɂ���Ĉړ����錻�ۂ�������B���̎����͋z���x�ɂ����f����A����̃s�[�N�������O��ɂ���Y�f�������ɑ��A�|���V�����ł͌������̑����Ƌ��ɋߎ��O��340nm�t�߂Ɏ��ʂ���B
�u���ł͂܂���b�����̘b��Ƃ��Ď��̓�̎������ʂ��Љ�ꂽ�B
�@���q�\����̋�Ԃł��鎩�R�̐ς̔��a�iFVR�j��z�d�q���Ŏ����@�ɂ���Č��ς������B
����́A�d�ׂ̈ړ����x�����߂�v���̓h���C���Ԃ̋����A����������Ύ卽�Ǝ卽�̋����Ɉˑ�����͂��ŁAFVR�͂��̖ڈ��ƂȂ�A�Ƃ̍l���Ɋ�Â������ł���B���̌��ʁAFVR��3.0�`3.7���̊Ԃ�Si�Ɍ������鑤�����q�̒�����傫���Ƃقڐ��̑��֊W������ꂽ�B�܂��A���E�ړ��x�̉��x��������z�b�s���O�T�C�g�̈ʒu�I�h�炬�������l�i���j�ɂ��Ă����l�̌��ʂ������Ă���B
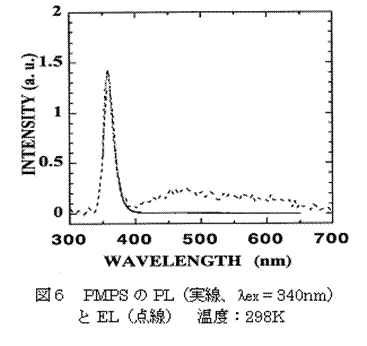 �A�|���V�������������ꒆ�ɂ����Ď卽�̌����𑵂����ꍇ�̕����I�e�����z���x�ω����w�W�ɂ��Ē��ׂ��B
�A�|���V�������������ꒆ�ɂ����Ď卽�̌����𑵂����ꍇ�̕����I�e�����z���x�ω����w�W�ɂ��Ē��ׂ��B
�卽�̌����𑵂���ƃz�b�s���O�T�C�g�̊Ԋu���ψ�ɂȂ�͂��ŁA���ہA�����̌��ʂ́A�卽�����E�ɑ��Đ����ɕ��ԁA�܂萂���ȕ����̃h���C���������邱�Ƃ��������B�܂��A���E�̋����Ƌ��ɗh�炬�̃t�@�N�^�[����������ȂǁA�������w�I�ɍ����I�Ȍ��ʂ�����ꂽ�B�����A�d�ׂ̈ړ��x�͉��p�ʂ̊��҂ɔ����Č��������B
���p�ʂł͓d�q�ʐ^�����̂ƗL�@EL�̓�̘b�肪�b���ꂽ�B
�O�҂́A�����I�ɂ͔ėp��Carlson�v���Z�X�ɂ̂��Ƃ�A�����̂ɓd�ړ��x�̑����|���V���X�`�������g�p�������̂ŁA�V�������nj^�Ƃ��Ē�Ă��ꂽ�w�ʘI�������ɂ�鎎��@���g�p���ē���ꂽ�������̃e�X�g�p�^�[������I���ꂽ�B���Ȃ݂ɁA���̕����͏��^�����\�ƌ������Ƃł���B
����A�d�ړ����x�̑����|���V�����͐}�U�Ō�����悤��360nm�ɋ����u��������������̂ŁA�����L�@EL�ɉ��p���邱�Ƃ��l������B�����ōޗ���Polymethylphenylsilane�iPMPS�j���g�p���A�z�ɂɓ�����ITO(Indium Tin Oxide)�A�A�ɂ�MgAg���g�����f�q�����삳�ꂽ�B�ŏ��A�d�ɑ����ɂ�錴���ʼn��������������肪���������A�A�ɑ����_�f�v���Y�}�������ĕ\�ʂ�SiO2�̋ɔ����≏�����`�������邱�Ƃʼn��P���ꂽ�B���̐≏���`���͓d�ׂ̒������������߂���ʂ������āA������������P���オ����n���������B���̑f�q�ɐF�f���R�[�g����R,G,B�J���[�̔����ɂ��������Ă���B
����A�≏���̌��ʂ�����ɒ��ׂ邽�߁A��蔖���ċψ��LB�����g���Č����Ƃ���A�t�ɉ����̌����傫�������錋�ʂƂȂ����B�����͂܂��s�������A���̔������x���\������̂ŁA���݁A����͔��F�����Ƃ��Ďg����ƍl���Ă���B
���āA����̃|���V�����̗L�@EL�ւ̎��p�I�ȉ��p�W�J�����A����͗L�@�u����̍H�v�Ȃǂɂ��ޗ��̂���Ȃ���P�Ɣ��������̌��オ���ߎ�ɂȂ�Ƃ̂܂Ƃ߂ł������B
�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�i���c�L�j